
蘋果與台積電合作下一代3奈米Ax晶片將採用Chiplet設計?
科技產業資訊室 (iKnow) - Kyle 發表於 2021年10月4日
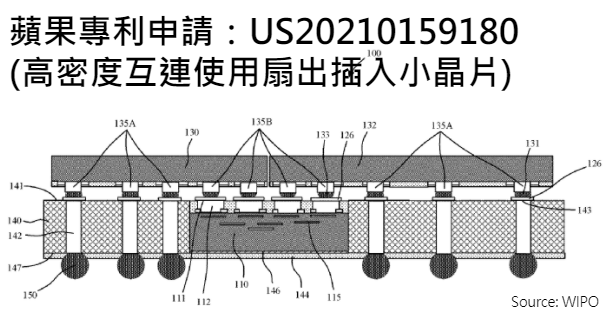
圖、蘋果專利申請:US20210159180 (高密度互連使用扇出插入小晶片)
借助3D Fabric技術,台積電的客戶可以使用小晶片(Chiplet),這些小晶片是用於創建更大整合電路的較小晶片。因為,該平台允許客戶繼續重複使用零組件中不變的部分,所以3D Fabric技術可以加快新技術的上市時間。換個角度來說,3D Fabric 允許將高密度互連晶片整合到封裝模組中,從而提供更高的頻寬、改善延遲和功率效率。
台積電在國際半導體產業協會(SEMI)舉辦的線上高科技智慧製造論壇上,提出了台積電的3D Fabric平台整合了先進測試、SoIC和2.5D先進封裝(InFO、CoWoS)等先進封裝測試技術。隨著先進製程技術進步到3奈米或以下,先進封裝的小晶片概念已成為必要的解決方案。
蘋果開發小晶片設計的工作開始於2017年,直到2021年3月,蘋果獲得了其小晶片設計的第一項專利,並於5月提交了更新(連結:US20210159180)。
蘋果指出,當前市場對行動電話、個人數位助理 (PDA)、數位相機、攜帶型播放器、遊戲和其他行動裝置等攜帶型和行動電子裝置的需求,變得更需要將更多性能和功能整合到空間越來越小的晶片內。因此,晶片的輸入/輸出密度和單個封裝內整合的晶片數量顯著增加。特別是各種2.5D和3D封裝解決方案,已被提議作為多晶片封裝解決方案,以連接單個封裝內的相鄰晶片。
基本上,蘋果的專利涵蓋半導體封裝和製造方法。由於蘋果是台積電3D Fabric平台技術的合作夥伴之一,因此合理推斷這兩家公司正在進一步探索在其晶片設計上使用小晶片。
不過,考慮到一旦開始出貨3奈米晶片,台積電勢必採用3D Fabric封裝平台。台積電原本應使用3奈米製程製造蘋果A16 Bionic晶片組,由於在該製程節點建構晶片的複雜性,使得台積電於2021年8月宣布延遲,因此A16 Bionic可能是使用4奈米製程節點製造。因此,目前尚不清楚iPhone 14中能夠看到3D Fabric封裝平台,但是隨著全球進入3奈米製程,往小晶片設計發展絕對是趨勢。(788字)
參考資料:
Apple's iPhone 14 may be one of the first to adopt 3nm + TSMC's 3D Fabric Platform. Patently Apple, 2021/9/23
Next year's iPhone 14 could be the first smartphone to use TSMC's new packaging platform. PhoneArena, 2021/9/24
High Density Interconnection using Fanout Interposer Chiplet. WIPO, 2021/5/27
相關文章:
1. AMD全面採用chiplet小晶片技術而獲得了技術優勢
2. SEMI:TSMC及Intel先進3D IC封裝技術
3. 台積電2021年技術論壇 4奈米提前試產、N5A支援汽車AI駕駛輔助
4. 台積電2020技術論壇:揭露先進製程最新時程表、2奈米將落腳新竹廠
5. 台積電2奈米將採用哪種技術?
6. 三星電子公佈半導體代工業務技術藍圖 3奈米可能優先用於自家晶片上
--------------------------------------------------------------------------------------------------------------------------------------------
【聲明】
1.科技產業資訊室刊載此文不代表同意其說法或描述,僅為提供更多訊息,也不構成任何投資建議。
2.著作權所有,非經本網站書面授權同意不得將本文以任何形式修改、複製、儲存、傳播或轉載,本中心保留一切法律追訴權利。
|