
AI晶片技術專利系列一-台積電的CoWoS技術獨霸世界
科技產業資訊室(iKnow) - 陳家駿、許正乾 發表於 2024年4月30日

圖、AI晶片技術專利系列一-台積電的CoWoS技術獨霸世界
眾所周知,人工智慧在生成式AI推波助瀾下,已進入一個新紀元。然而,AI要能在各應用場域充分發揮效能,除了依賴機器或深度學習等不同的演算法之外,要將AI的應用發揮到極致,勢必要靠AI晶片來實現。AI晶片是專門設計並用於執行AI演算法(如CNN、RNN、Transformer等模型)的晶片,可優化平行計算與加速記憶體存取等,相較於一般的晶片更能提升AI演算法的計算速度與推理能力。如今聲量如日中天的生成式AI,正需要透過AI晶片才能達到如圖像識別、語音辨識、自然語言處理、自動駕駛、智慧物聯網、文化創作等等各種應用之場景。
至於2024年科技圈,AI晶片重要的應用之一是放在「AI PC」上。所謂的AI PC是將是個人電腦搭載AI晶片,特別是指可在本地端執行AI演算法,而無需依賴雲端,這樣的優點是速度快、耗能低,並降低和雲端連結過程中所帶來的資安風險。然而,AI晶片的良窳涉及半導體製程技術,也因此帶動幾個科技巨頭展開「晶片大戰」的競賽。鑑於篇幅有限,本系列擬從專利之角度,特別從全球半導體的幾個大咖各自之patent portfolio中,挑選具代表性的專利,來看看其等如何針對AI晶片做技術布局。
首先,當然是我國享譽全世界的護國神山!台積電TSMC的股價在今年3月飆高,正是受惠於AI晶片需求旺盛,加上半導體的先進製程與封裝,使得台積電已成為「一個人的武林」,而其中CoWoS(Chip-on-Wafer-on-Substrate)技術,正是台積電獨霸全球的秘密武器之一,其應用領域十分廣泛,包含高效能運算HPC、AI伺服器、數據中心、5G通訊、物聯網、車用電子等。
CoWoS是一種先進的半導體封裝技術,主要針對7奈米以下的晶片。CoWoS可進一步拆分為CoW和WoS,CoW就是將晶片堆疊在晶圓上(Chip-on-Wafer),而WoS就是基板上的晶圓(Wafer-on-Substrate)。CoWoS又分成2.5D與3D版本的封裝技術,其差別在於堆疊的方式不同。2.5D封裝是部分晶片堆疊在基板上,而3D封裝則是全部晶片都堆疊在基板上,其中2.5D封裝是目前主流且可量產的技術。
如圖1所示,2.5D封裝為水平堆疊晶片,主要將系統單晶片(SoC)與高頻寬記憶體(HBM)設置在中介層(interposer)上,先經由微凸塊(micro bump)連結,使中介層內的金屬線可電性連接不同的SoC與HBM,以達到各晶片間的電子訊號順利傳輸,然後經由矽穿孔(Through-Silicon Via, TSV)技術,來連結下方PCB基板(substrate),讓多顆晶片可封裝一起,以達到封裝體積小、功耗低、引腳少、成本低等效果。著名的Nvidia的GPU H100更是供不應求,其中H100正是採用台積電的2.5D封裝的CoWoS技術。
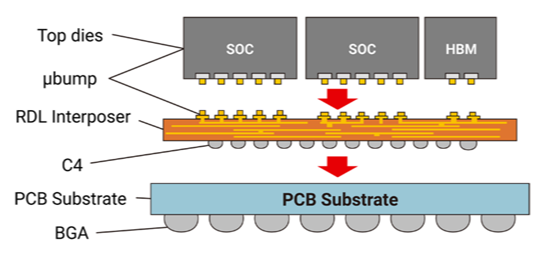
圖1、CoWoS的2.5D封裝技術示意圖
3D封裝則是垂直堆疊晶片,雖然優點在於,使用矽穿孔來連結垂直方向上之不同晶片的電子訊號,使訊號延遲得以降低,但目前受限於設計、量產或供應鏈皆還不夠成熟,所以基於成本考量,目前業界仍多採用2.5D封裝。
既然2.5D是目前的主流,那麼針對台積電的2.5D封裝,並根據以上的技術特徵「CoWoS是一種先進的半導體封裝技術……,經由矽穿孔(Through-Silicon Via,TSV)技術來連結下方PCB基板(substrate),讓多顆晶片可封裝一起」,輸入到AI系統Lupix [1],並針對近10年的專利數據中,掃描出許多與CoWoS相關具有市場價值且已獲證之專利。
在眾多相關專利中,最受囑目的是標題為「矽中介板結構、封裝體結構以及矽中介板結構的製造方法」(以下稱本專利),其台灣專利號為TWI553802B,而其對應的美國專利為「三維IC結構與半導體晶圓的混合鍵結方法」(Three dimensional integrated circuit structures and hybrid bonding methods for semiconductor wafers, US9978637B2),分別於2016/10/11和2018/05/22獲證。根據AI系統Lupix針對當下的技術演化趨勢去做計算,推斷本專利在機電技術領域的專利價值之PR值(Percentile Rank)為98,也就是說,其專利價值高過98%的機電技術領域,包含半導體、IC設計、光電、網路通訊、車用電子、封裝測試等專利文獻。
本專利之所以重要,是因為台積電的CoWoS技術在先進製程與封裝中,其中介層的結構設計功不可沒。如圖2所示,是台積電在本專利中所揭露的三維IC結構;而圖3所示,即為圖2中的金屬墊(127)上嵌入一個介電結構(212、213),也是本專利中最重要的技術特徵,透過這樣的設計,可減少在化學機械研磨(Chemical Mechanical Polishing, CMP)所帶來的「碟化效應」(Dish Effect),而這種效應在10奈米以下的製程尤其需要避免,若處理不好將會嚴重影響半導體製程的可靠度與良率。
圖2、台積電在本專利中所揭露的三維IC結構之示意圖
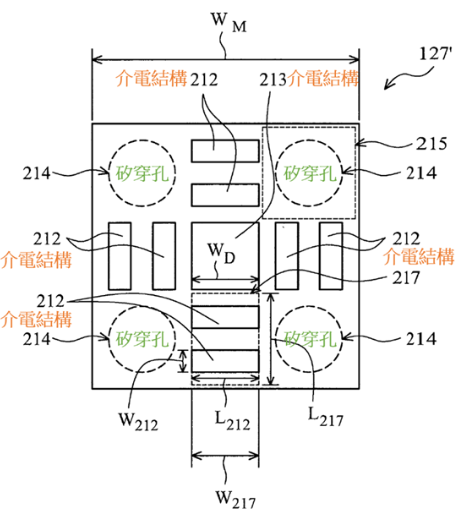
圖3、於圖2中的金屬墊(127)上嵌入一個介電結構(212、213)之示意圖
根據本專利的權利保護範圍來看,圖2中的晶粒(110A)可為如CPU或GPU等處理器,而晶粒(110B)可為SRAM或DRAM等記憶體。當處理器和記憶體在執行運算過程中,電子訊號可經過中介層(120’)的矽穿孔(125) ,傳送電子訊號至基板(130’)。這樣的結構不僅方便傳導電子訊號,更能透過矽穿孔(125)散熱與易於封裝等優點。更值得一提的是,圖3中虛線圓圈所示的位置(214),正是矽穿孔(125)貫穿中介層(120’)至導電結構(129)之處。
為了確保良率,建議設置2至4個矽穿孔。金屬墊(127)對每一金屬墊127而言,兩個或多個位置214係連接於矽穿孔125。由於金屬墊(127或127’)的角落區域(215)較不易受CMP的碟化效應影響,所以區域(215)就不嵌入介電結構,如此一來,本專利的三維IC結構就可提供低電阻與良好的導電性。
為了降低碟化效應所帶來的衝擊,本專利還更進一步地界定介電結構(213)與介電結構(212,即長方形)。介電結構(213)的WD/WM的比值需介於1/4至1/2之間,其中WD介於約10微米至25微米,這樣就可換算出WD需要多少值。至於介電結構(212)的寬度W212大約介於1/5至1/4倍的長度(L217),實作時可為2微米至5微米之間。
本專利可回溯到美國優先權申請日2013-10-11,可見台積電研發內部至少在2013年(甚至比2013年還要更早),早就洞見到半導體製程之物理極限帶來許多艱難的技術挑戰,必須要有新的突破思維與方案。
半導體的先進製程是技術、資金、人才與政治因素的世紀大對決,目前全世界也只有台積電、英特爾與三星有能力逐鹿爭雄於半導體先進製程的晶片製造,所以本AI晶片技術系列的下一回,將解析第二個巨頭「英特爾」在半導體先進封裝,對於2.5D封裝的相關技術與專利。(2256字;圖4)
作者資訊:
陳家駿律師 台灣資訊智慧財產權協會理事長
許正乾執行長 因子數據股份有限公司共同創辦人
註解:
參考資料:
The Chronicle of CoWoS. TSMC.
An In-Depth Explanation of Advanced Packaging Technology: CoWoS. Trendforce,2023/08/08.
Mechanism for forming patterned metal pad connected to multiple through silicon vias (TSVs). Google Patents.
矽中介板結構、封裝體結構以及矽中介板結構的製造方法。Google Patents。
相關文章:
1. 三星反訴華碩筆電侵害WIFI專利,華碩技術授權公司因應追加主張被三星侵害專利
2. 全球生成式AI相關之訴訟大觀-- 盤點OpenAI、Microsoft、Meta、Midjourney等AI官司
3. 媒體巨擘控告ChatGPT著作侵權案 --New York Times v. Microsoft & OpenAI
4. BenQ欲排除涉嫌侵權的螢幕夾燈於Amazon銷售,銷售商ALPINE 提出確認產品不侵權訴訟
5. ChatGPT公益私利之定位:科技教父的世紀官司 --Musk強勢回歸告Altman與Open AI (系列三 Musk掀起法律戰端 -- 想將AI解放成「天下為公」?)
6. ChatGPT公益私利之定位:科技教父的世紀官司 --Musk強勢回歸告Altman與OpenAI (系列二 變調的AGI -- 從開放到封閉 v. 從公益到營利)
--------------------------------------------------------------------------------------------------------------------------------------------
【聲明】
1.科技產業資訊室刊載此文不代表同意其說法或描述,僅為提供更多訊息,也不構成任何投資建議。
2.著作權所有,非經本網站書面授權同意不得將本文以任何形式修改、複製、儲存、傳播或轉載,本中心保留一切法律追訴權利。
|