
Fractilia推出FAME全新隨機性誤差的量測解決方案 協助EUV良率難題
科技產業資訊室 (iKnow) - May 發表於 2022年3月29日
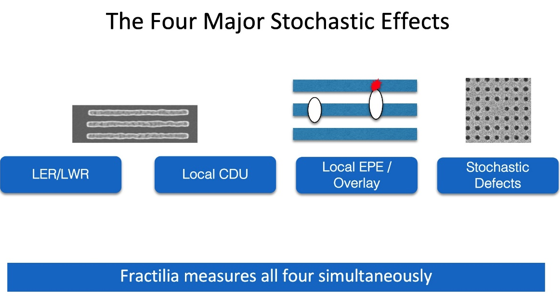
圖、Fractilia的FAME平台可同時量測所有主要的隨機效應
Fractilia推出的FAME™可提供晶圓廠高精準度的隨機性誤差的量測解決方案,來克服EUV先進製程上最大的微影圖案化錯誤。
台北,2022年3月29日 — 適用於先進半導體製造的隨機性(stochastics)微影圖案誤差量測與控制解決方案業者Fractilia,今天宣布推出最新版本的Fractilia自動化量測平台(FAME™),讓半導體晶圓廠得以管控因受到隨機性誤差影響甚鉅的極紫外光微影(EUV)製程所產生的良率問題,而這項挑戰損失的金額可達數十億美元。
FAME平台提供獨特且具高精準度的隨機性微影圖案誤差量測,而隨機性誤差是先進製程上最大的微影圖案(patterning)錯誤來源。晶圓廠在FAME™的協助下,能更快做出更好的決策,以解決隨機性微影圖案誤差這個新型良率殺手,並拿回對先進微影圖案製程的控制權,同時提升元件良率與曝光機與蝕刻機的生產力。此一最新發表的FAME版本建構於Fractilia經驗證的第三代Fractilia反向線掃描模型(Fractilia Inverse Linescan Model;FILM™)工具,該平台已獲前五大晶片製造商當中的四家業者採用,協助EUV從實驗室進入晶圓廠的實用工具。
隨機性誤差的兩難:如何管控無法量測準確的目標值
微影隨機性誤差是隨機出現且不會重複的圖案化錯誤。在EUV製程中,微影製程圖案錯誤的製程容錯空間,可能超過一半都耗費在隨機性誤差上。晶圓廠要控制這個問題就必須量測製程隨機性誤差;然而,現有的方法並不夠準確,而先進製程晶圓廠已無法負擔因忽視隨機性誤差所導致良率損失的後果。製程隨機性誤差對於先進波長193奈米光學微影,早已是個問題,特別是雙重曝光和四重曝光微影製程,而在EUV製程中,由於圖案進一步微縮,製程隨機性誤差則會更大幅降低良率而造成成本大幅提升。
Fractilia技術長Chris Mack表示:「製程隨機性誤差迫使晶圓廠必須在良率與生產力間取捨。業者不是得增加EUV曝光的劑量來降低隨機誤差,以避免良率的損失,就是得額外增加一台EUV掃描機來彌補流失的生產力。藉由精準量測並控制製程隨機性誤差,晶圓廠可以優化並提升內部製程設備的生產力及良率。FAME平台具備獨特的功能,能以高精準度量測並控制隨機性誤差,為客戶帶來無法透過其它方式取得的全新製程優化選項與解決方案。我們觀察到,客戶使用我們的產品量測到的掃描式電子顯微鏡(SEM)影像數量呈指數成長,這也讓Fractilia成為業界公認的製程隨機性圖案誤差量測標準。」
「精準去除量測雜訊」的量測值能為晶圓製造變異提供完整全貌
FAME平台使用專有且獨特、符合物理定律的SEM建模與資料分析方式,可從SEM影像量測並修正量測機台上隨機與系統性的雜訊,提供晶圓微影圖案上實際的量測值,而非影像上參雜量測機台雜訊的圖案量測值。這些「修正」的製程實際隨機性誤差的量測值,可以讓晶圓廠的工程師更加瞭解、優化製程並解決良率的問題。
FAME平台可同時量測所有主要的隨機效應,包括線邊粗糙度(LER)/線寬粗糙度(LWR)、局部線寬均勻度(LCDU)、局部邊緣圖案置放誤差(LEPE)、隨機缺陷偵測及其他效應。FAME平台提供業界最佳的訊號對訊噪的邊緣偏移檢測,訊噪比相較於其它解決方案多出高達五倍,且每張SEM影像可以擷取出超過30倍的特徵資料。FAME平台適用於所有的SEM量測工具廠商及所有的SEM量測機型。
Fractilia的FAME平台可同時量測所有主要的隨機效應,包括線邊粗糙度(LER)/線寬粗糙度(LWR)、局部線寬均勻度(LCDU)、局部邊緣圖案置放誤差(LEPE)、隨機缺陷偵測及其他效應。FAME平台最新版本的新功能包括:
- 對訊噪或對比偏低的先進微影影像,仍可取得精準的量測值,例如應用於高數值孔徑(high-NA)EUV製程的超薄光阻微影圖案的隨機效應量測。
- 能為下凹(Hole)與上凸(Pillar)的接觸窗圖案提供前所未見的絕佳、精準的局部線寬均勻度(LCDU)量測值。
- 獨特的「機率性製程容錯範圍(Probabilistic Process Window)」功能,可同時對多個製程敏感微影圖案,設定個別的多個隨機製程規格,也把量測的不確定性納入考量最終改善對曝光機的控制。
針對製程開發及工程分析應用,Fractilia透過MetroLER™,提供同樣高精準度的隨機性製程誤差量測效能,這款產品也已經發展到第三代的FILM工具。
關於Fractilia
Fractilia總部位於美國德州奧斯汀,是先進半導體製造中隨機性(stochastic)誤差量測與控制解決方案業者,應用Fractilia反向線掃描模型(Fractilia Inverse Linescan Model;FILM™)的專利技術,提供高精準度的隨機性誤差量測。隨機性誤差是先進製程上最大的微影圖案(patterning)錯誤來源,客戶可以透過FAME™提升元件的良率、效能,以及先進曝光機、蝕刻機的生產力。Fractilia的產品為整個半導體製造產業提供微影及蝕刻製程最佳化的解決方案。Fractilia的解決方案包括:製程開發與工程分析使用的MetroLER™,及提供晶圓廠提升良率與生產應用的Fractilia自動化量測平台(Fractilia Automated Measurement Environment;FAME™)。 (1678字;圖1)
參考資料:
Fractilia新聞稿,2022/3/29。
相關文章:
1. 三星華城V1生產線 部分5奈米代工良率低於50%
2. 三星決心GAA搶先台積電推出 但良率是利潤關鍵
3. GAA相關專利數量快速增長 台積電以31.4%居第一
4. 英特爾訂購下一代High-NA EUV微影機 期望在2025年實現量產
5. 邁入3奈米,EUV與相關周邊設備也須跟上晶片製造商腳步才是關鍵
6. EV GROUP透過次世代步進重複奈米壓印微影系統 高效生產微縮化
--------------------------------------------------------------------------------------------------------------------------------------------
【聲明】
1.科技產業資訊室刊載此文不代表同意其說法或描述,僅為提供更多訊息,也不構成任何投資建議。
2.著作權所有,非經本網站書面授權同意不得將本文以任何形式修改、複製、儲存、傳播或轉載,本中心保留一切法律追訴權利。
|