
博通聯手台積電強化CoWoS平台 運用3D堆疊提高運算力
科技產業資訊室 (iKnow) - May 發表於 2020年3月4日
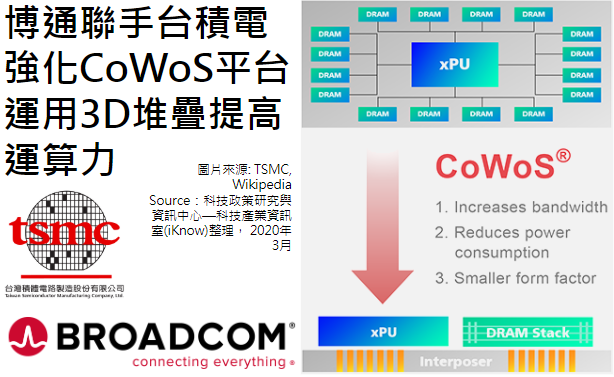
圖、博通聯手台積電強化CoWoS平台 運用3D堆疊提高運算力
台積電公司(TSMC)於2020.3.3宣布與博通公司(Broadcom)攜手合作強化CoWoS®平台(基板的晶圓上晶片封裝),運用晶片堆壘技術提升產品的運算能力,支援先進的高效能運算系統,此技術也將支援下一代的5奈米製程技術。也就是說,CoWoS平台以支援業界首創且最大的兩倍光罩尺寸(2X reticle size)之中介層,面積約1,700平方毫米。此項新世代CoWoS中介層由兩張全幅光罩拼接構成,能夠大幅提升運算能力,藉由更多的系統單晶片來支援先進的高效能運算系統,並將支援台積電下世代的5奈米製程技術。
此項新世代CoWoS技術能夠容納多個邏輯系統單晶片(SoC)、以及多達六個高頻寬記憶體(HBM)立方體,提供高達96GB的記憶體容量;此外,此技術提供每秒高達2.7兆位元的頻寬,相較於台積公司2016年推出的CoWoS解決方案,速度增快2.7倍。
CoWoS解決方案具備支援更高記憶體容量與頻寬的優勢,非常適用於記憶體密集型之處理工作,例如深度學習、5G網路、具有節能效益的數據中心、以及其他更多應用。除了提供更多的空間來提升運算能力、輸入/輸出、以及HBM整合,強化版的CoWoS技術亦提供更大的設計靈活性及更好的良率,支援先進製程上的複雜特殊應用晶片設計。
在台積公司與博通公司合作的CoWoS平台之中,博通定義了複雜的上層晶片、中介層、以及HBM結構,台積公司則是開發堅實的生產製程來充分提升良率與效能,以滿足兩倍光罩尺寸中介層帶來的特有挑戰。
透過數個世代以來開發CoWoS平台的經驗,台積公司創新開發出獨特的光罩接合製程,能夠將CoWoS平台擴充超過單一光罩尺寸的整合面積,並將此強化的成果導入量產。
該CoWoS平台,解決許多在7奈米及更先進製程上的設計挑戰。藉由雙方的合作,藉由運算能力、輸入/輸出、以及記憶體整合來驅動創新,同時為包括人工智慧、機器學習、以及5G網路在內的嶄新與新興應用產品鋪路。
CoWoS是台積公司晶圓級系統整合組合(WLSI)的解決方案之一,能夠與電晶體微縮互補且在電晶體微縮之外進行系統級微縮。除了CoWoS之外,台積公司創新的3D積體電路技術平台,例如整合型扇出(InFO)及系統整合晶片(SoIC),透過小晶片分割與系統整合,以達到更強大的功能與強化的系統效能。
台積電表示強化版的 CoWoS 技術提能支援先進製程之複雜特殊應用晶片設計。(790字;圖1)
參考資料:
台積公司與博通強化業界首創兩倍光罩尺寸中介層之CoWoS平台。台積公司,2020/3/3。
相關文章:
1. 台積電與意法半導體合作加速市場採用GaN氮化鎵產品
2. 5奈米及3奈米戰爭=台積電與三星對壘
3. 扇出型封裝材料及設備市場2018-2024以20%成長
4. AMD全面採用chiplet小晶片技術而獲得了技術優勢
5. COVID-19疫情對半導體產業影響,從2020第二季才是挑戰開始
--------------------------------------------------------------------------------------------------------------------------------------------
【聲明】
1.科技產業資訊室刊載此文不代表同意其說法或描述,僅為提供更多訊息,也不構成任何投資建議。
2.著作權所有,非經本網站書面授權同意不得將本文以任何形式修改、複製、儲存、傳播或轉載,本中心保留一切法律追訴權利。
|